- 型号 & 关键词搜索
- 交叉搜索
- 参数搜索
- 库存查询与购买
This webpage doesn't work with Internet Explorer. Please use the latest version of Google Chrome, Microsoft Edge, Mozilla Firefox or Safari.
请输入3个以上字符 Search for multiple part numbers fromhere.
The information presented in this cross reference is based on TOSHIBA's selection criteria and should be treated as a suggestion only. Please carefully review the latest versions of all relevant information on the TOSHIBA products, including without limitation data sheets and validate all operating parameters of the TOSHIBA products to ensure that the suggested TOSHIBA products are truly compatible with your design and application.Please note that this cross reference is based on TOSHIBA's estimate of compatibility with other manufacturers' products, based on other manufacturers' published data, at the time the data was collected.TOSHIBA is not responsible for any incorrect or incomplete information. Information is subject to change at any time without notice.
请输入3个以上字符
MOSFET与IGBT之间有何区别?
MOSFET和IGBT都是以电压驱动的功率半导体器件,但其适用的应用范围不同。一般而言,MOSFET主要用于要求高速开关的中低电压应用,而IGBT则广泛应用于高电压和大电流应用场合。这些差异源于两者在器件结构以及导通过程中载流子行为方式上的不同。本常见问题(FAQ)对MOSFET和IGBT的结构、工作原理、导通特性和开关特性进行比较,并说明如何根据具体应用选择合适的器件。
MOSFET与IGBT的结构差异
MOSFET(金属氧化物半导体场效应晶体管)和IGBT(绝缘栅双极型晶体管)都是通过电气绝缘的栅极电极来控制电流的电压驱动型功率器件。两种器件均采用电流从芯片正面流向背面的垂直结构,其中漂移区(n⁻层)决定了器件的耐压能力。
两种器件在结构上的主要差异在于漂移区背面层结构的不同。
图1和图2显示了MOSFET和IGBT的电路符号、器件结构以及简化的等效电路。
在图1所示的MOSFET简化等效电路中,对高耐压MOSFET导通特性起主导作用的漂移区电阻以简化形式进行表示。
相比之下,图2中IGBT的简化等效电路并未描绘完整的PNP晶体管结构,而是通过一个对应于p+集电极与漂移区之间pn结的二极管来表示少数载流子注入机制。
有关MOSFET结构的更多详细信息,请参阅以下常见问题(FAQ):
> MOSFET有哪些结构类型?
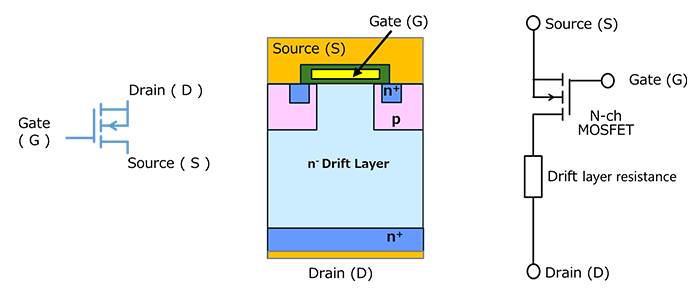
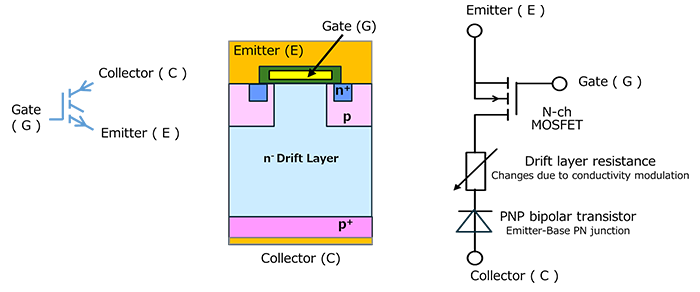
MOSFET与IGBT工作原理的差异
由于结构上的不同,MOSFET与IGBT在导电过程中所涉及的载流子类型以及载流子的输运行为方面均存在差异。
MOSFET的工作原理
在MOSFET中,通过施加栅极电压在源极与漏极之间形成导电沟道,从而使电流得以流动。
在导通过程中,电流仅由多数载流子(电子或空穴)承担。
由于MOSFET完全依靠多数载流子工作,因此被归类为单极型器件,其漂移区中不会发生载流子存储。
因此,MOSFET能够实现快速的开通与关断,适用于高速开关运行。
有关MOSFET工作原理的详细说明,请参阅以下常见问题(FAQ):
>了解MOSFET的工作原理与机制
IGBT的工作原理
除通过MOS栅极形成沟道进行控制之外,IGBT还利用位于集电极侧的p⁺层向漂移区注入少数载流子。
当施加栅极电压时,会形成MOS沟道,同时少数载流子(空穴)从p⁺集电极层注入到漂移区。与此同时,MOS沟道的形成使得电子能够从n⁺发射极侧被注入。
随着空穴注入漂移区,为了维持准中性条件*,必须避免半导体内部出现电荷不平衡。
因此,漂移区中的电子浓度相应增加,形成电子和空穴以高密度同时存在的状态。
由于两种载流子都以高浓度存在,漂移区的导电能力显著提高。
这种现象被称为电导率调制。
图3基于图2所示的结构,以示意方式展示了电导率调制过程中漂移区内的载流子行为,可以看到来自集电极侧注入的空穴与从发射极侧提供的电子同时共存于漂移区中。
在正常情况下,漂移区中的载流子浓度由掺杂浓度决定,并保持在平衡状态。然而在IGBT中,由于少数载流子注入,载流子浓度会大幅高于该平衡水平。
这种注入的载流子在漂移区内停留一定时间的状态被称为载流子存储。
有关更多详细内容,请参阅以下常见问题(FAQ):
>什么是电导率调制?
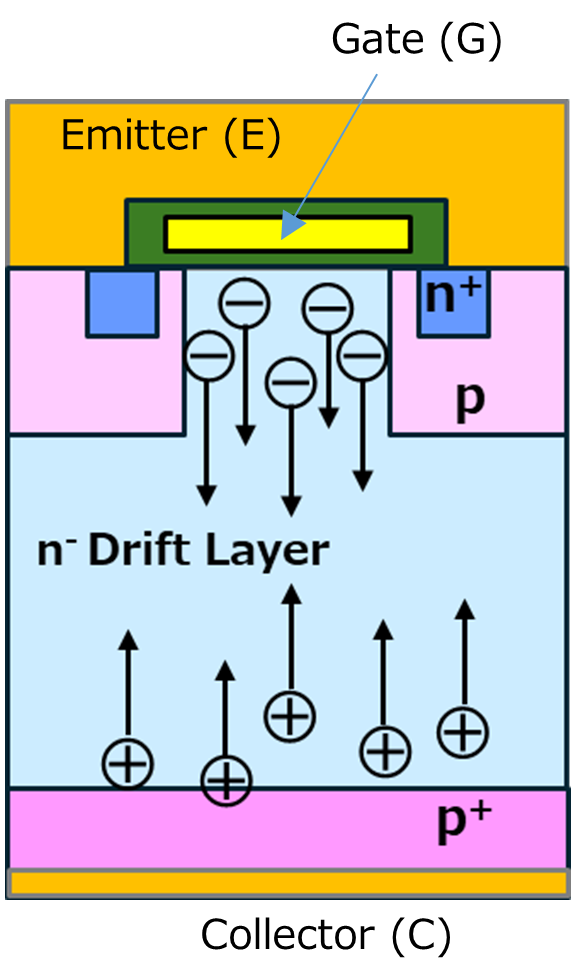
*:准中性是指半导体某一区域内电子(−)与空穴(+)的电荷几乎彼此抵消,从而使空间电荷可以忽略不计的一种状态。
工作原理差异对开关特性的影响
由于MOSFET中不存在载流子存储,其开通与关断过程几乎能够立即响应栅极电压的变化,从而实现高频开关运行。
相比之下,IGBT的漂移区中会发生载流子存储。在关断过程中,存储的少数载流子必须经过复合或被移除后,电流才能完全停止。因此,在栅极关断之后,电流仍会在短时间内持续流动,使其开关速度慢于MOSFET。
这种在关断后仍然存在的剩余电流分量被称为拖尾电流。
拖尾电流是IGBT关断过程中由于双极型工作方式下少数载流子存储而产生的特有现象,而在MOSFET等单极型器件中不会出现。
MOSFET与IGBT导通特性的差异
在高压MOSFET中,为了获得足够的耐压能力,漂移区必须设计得较厚且掺杂浓度较低。因此,漂移区的电阻分量成为导通电阻的主要组成部分,并且导通压降会随着电流的增加而上升。
相比之下,在IGBT中,由于少数载流子的注入产生导电调制,使漂移区内的载流子浓度显著提高。
图4显示了IGBT与MOSFET导通电压特性的比较示例。
结果表明,在低电流区域中MOSFET具有较低的导通电压,而在高电流区域中IGBT则表现出更低的VCE(sat)。
因此,导通状态下电压随电流变化所呈现出的不同行为,反映了MOSFET与IGBT在导通特性上的根本差异。
图4注:
图4比较了IGBT与高耐压MOSFET的导通电压特性
(此处以超结MOSFET作为代表性示例)
横轴表示导通电压——MOSFET对应VDS(on),IGBT对应VCE(sat)——纵轴表示导通电流。图中给出了环境温度为25℃和150℃时的特性。
在低电流区域,MOSFET的导通电压几乎从0V开始上升。相比之下,由于pn结产生的电压分量,IGBT的导通电压起始值较高,表现出类似二极管的正向电压偏置。
在高电流区域,IGBT特性的斜率变得更陡,当电流超过一定水平后,IGBT的VCE(sat)低于MOSFET的VDS(on)。
有关超结MOSFET结构的详细说明,请参阅以下常见问题( FAQ):
>MOSFET有哪些结构类型?
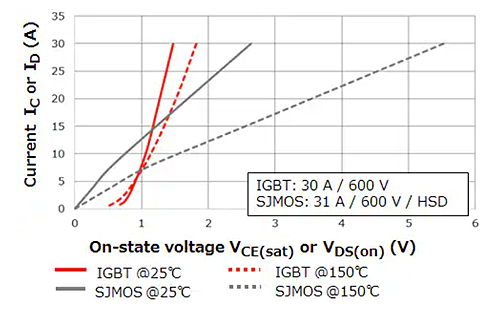
总结:如何在MOSFET与IGBT之间进行选择
由于结构和工作原理的差异,MOSFET与IGBT在导通特性和开关特性之间存在不同的权衡取舍。
MOSFET适用于对低导通电阻和高速开关有要求的中低电压应用,尤其适合高频运行场合。
另一方面,IGBT由于少数载流子注入和电导率调制效应,在高电压和大电流条件下能够提供更优异的导通性能。
但同时需要注意,由于载流子存储引起的尾电流,IGBT在关断时的开关速度相对较慢。
因此,综合考虑电压等级、电流大小以及开关频率等要求,在充分理解上述取舍关系的基础上,可选择最适合具体应用的器件类型。
典型的应用领域包括:
- MOSFET
需要高速开关的中低电压应用
(例如:开关电源、DC‑DC变换器、高频电路) - IGBT
相对较低开关频率的高电压和大电流应用
(例如:逆变器、电机驱动、工业电力变换系统)
理解导通特性(RDS(on)/VCE(sat))、导通损耗以及开关损耗之间的权衡关系,对于为各类应用选择最合适的器件至关重要。
| BJT | MOSFET | IGBT | |
|---|---|---|---|
| 驱动类型 | 电流驱动 |
电压驱动 |
电压驱动 |
| 驱动功耗 | 高 | 低 | 低 |
| 导通电压 | 中等 | 随击穿电压升高而趋于增大 |
低 |
| 开关速度 | 低 |
高 |
中等 |
| 温度稳定性 | 差 | 好 | 好 |
| 实现高耐压的难度 | 中等 | 高 | 借助电导率调制易于实现 |
相关信息
以下文档中也包含相关信息。
参数搜索
IGBT/IEGT
常见问题(FAQ)
*本常见问题(FAQ)中所使用的公司名称、产品名称和服务名称可能分别属于其各自的公司。



