东芝和日本半导体株式会社研发了旨在提高模拟IC用P沟道LDMOS可靠性的新技术
2020年09月23日
东芝电子元件及存储装置株式会社
日本半导体株式会社
东京—东芝电子元件及存储装置株式会社(“东芝”)及其制造生产子公司日本半导体株式会社(Japan Semiconductor Corporation)研发了一种旨在提高模拟IC用P沟道横向双扩散MOS(P沟道 LDMOS)技术可靠性的技术。这两家公司阐明了漏极雪崩热载流子(DAHC)应力测试(LDMOS的可靠性测试)中击穿电压下降的原因,并确定了抑制此电压下降的器件结构。
详情可参见由IEEE主办并在线举行的2020年功率半导体器件和IC国际研讨会(ISPSD 2020)报告。
车辆的电气化和工业设备的自动化正不断刺激市场对于适用于低温和高温环境中长期保持高度可靠性的模拟IC的需求。因此,具有低导通电阻,适合于广泛应用的LDMOS引起了极大的关注。
在漏极雪崩热载流子(DAHC)应力测试中,我们在LDMOS栅极上长时间施加中压以评估LDMOS的可靠性。该测试测量了击穿电压的下降,因为击穿电压下降是已知的模拟IC损坏和可靠性降低的原因。
到目前为止,导致击穿电压下降的机制原理尚未十分明确,但普遍认为是由于浅沟隔离(STI)[1] 角落的陷阱电荷所引起,那里碰撞电离率最高。但是近来两家公司通过对电子流和器件结构进行调查,发现了不同的原因,陷阱电荷位于STI底部,而不是浅沟隔离角落。
两家公司发现,RESURF结构[2]比更常用的DRIFT(漂移)结构[3]对于击穿电压的下降具有更强的耐受性,因为漂移区下方的一个附加结平衡了整个区域的总电场。RESURF结构的下降抑制可达到漂移结构的三分之二。 [4]
漂移和RESURF的P沟道LDMOS结构的横截面
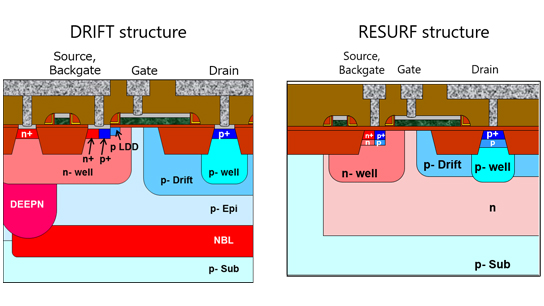
DAHC应力测试证明可靠性提高
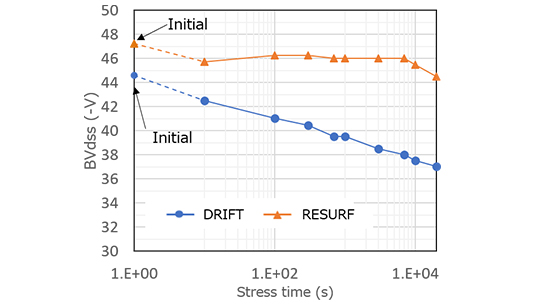
注:
[1] STI:浅沟隔离。将绝缘薄膜嵌入浅沟以划分元件或电极。
[2] DAHC应力测试5.5小时后比较击穿电压的下降。漂移结构中击穿电压下降了7.6V,而RESURF结构中击穿电压仅下降了2.8V。
[3] 漂移结构:一种LDMOS结构,其中P沟道漂移区域被同一P沟道区域所包围。
[4] RESURF结构:一种LDMOS结构,其中P沟道漂移区域被N沟道区域所包围。
客户问询:
日本总部
系统器件销售&市场部
销售促进组
电话:+81-3-3457-3332
中国地区
系统LSI市场部(System LSI Marketing)
电话:021-6090-0610/深圳:0755-3661-5889
* 本文档中的产品价格和规格、服务内容和联系方式等信息,在公告之日仍为最新信息,如有变更,恕不另行通知。
* 本文提及的公司名称,产品名称和服务名称可能是其各自公司的商标。